一、背景
在电子技术高速迭代的当下,电路性能与可控性已成为产品核心竞争力的关键。随着工业交换机集成度持续提升、工作频率不断攀升,其运行过程中产生的热量显著增加 —— 这不仅会直接影响内部电路的稳定性与元器件使用寿命,更可能引发系统故障,成为制约设备可靠运行的核心瓶颈。因此,针对交换机 PCB 板的散热分析与设计,已成为电子工程师在产品研发阶段必须攻克的关键课题。
二、目的
核心目标是控制产品内部所有电子元器件的工作温度,确保其在既定工作环境条件下,不超过相关标准及规范规定的最高允许温度。
最高允许温度的计算需以元器件应力分析为基础;温度阈值需与产品可靠性要求、各元器件分配的失效率指标保持一致。
三、关键词解释
散热:指将发热器件产生的热量高效发散至环境中的过程,核心技术原理包括热传导、热对流、热辐射三类,三者常协同作用实现散热。
热传导:热量从物体高温部分向低温部分传递,或在接触的不同物体间传递,是固体中热传递的主要形式。例如:工业交换机中 CPU 散热片底座与芯片直接接触,将核心热量导出。
热对流:液体或气体中,较热部分与较冷部分通过循环流动实现温度均衡的过程,是流体特有的热传递方式。例如:交换机内置散热风扇带动腔体内空气流动,加速热量散发。
热辐射:物体通过电磁波(射线)形式向外传递热量,无需依赖介质即可实现,是真空中唯一的热传递方式。例如:交换机金属外壳通过热辐射向周围环境散发热量。
四、散热设计方法
散热设计需遵循 “先明确需求→初步设计→样机验证→优化迭代” 的核心流程:先确定发热器件功率、温度阈值等核心参数,再在 PCB 设计阶段制定初步散热方案,通过样机测试验证方案在散热效果、使用寿命、成本控制等维度的适配性,达标则方案落地,未达标则重新优化设计。
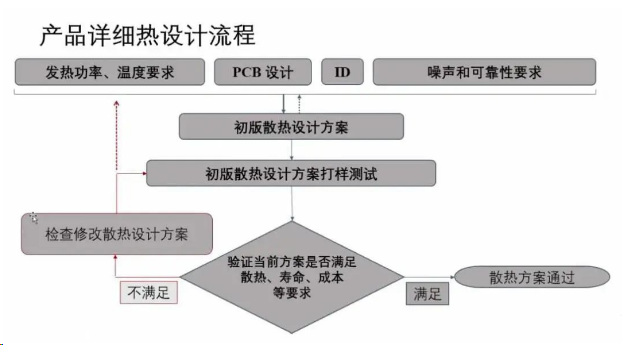
PCB 板层面散热设计
PCB 板是散热系统的基础载体,其设计合理性直接决定散热效率,核心围绕 “器件识别、布局优化、PCB 结构升级” 三大方向展开。
1)发热器件识别
工业交换机的主要发热器件包括:防反二极管、功率电感、电源芯片及模块、控制芯片、交换芯片、PHY 芯片、核心控制板、光模块等,设计前需精准定位各类器件的发热功率与温度耐受范围。
2)器件合理布局(核心原则)
合理布局是规避热岛效应、提升散热效率的基础,需遵循以下原则:
①发热量大的器件(如功率器件、核心处理器)优先布置在散热条件优越区域(如靠近通风孔、可通过金属导体连接外壳的位置);
②避免多个高发热器件集中布置,防止局部温度过高形成热岛;
③热敏器件(如电池、电容等)需避开发热源,或采取防护措施;若必须靠近热源,应安装在热源下方,且器件横向安装面与风向保持平行,适配热对流规律;
④高发热器件需预留散热器固定孔位与安装空间,优先布置在气流进出口位置;
⑤自然对流场景下,热流通道需满足 “短路径、大横截面积” 要求;
⑥冷却气流流速较低时,器件采用叉排方式排列,增强气流紊流程度,提升散热效果;
⑦发热器件不直接安装在机壳上时,两者间距需≥35-40cm,避免热量传导至机壳后影响其他部件。
3)PCB 散热结构优化
①散热焊盘与开窗设计:针对 DPAK、D2PAK、QFN 等大功耗封装器件,在其周边预留散热孔阵,PCB 正反面适当开窗,便于后续通过额外散热措施将热量传导至金属板等散热载体。
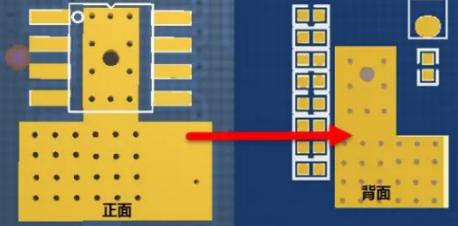
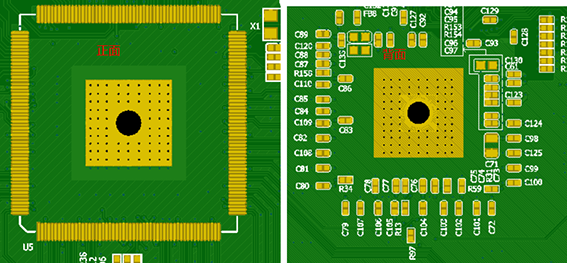
②散热过孔阵设计:散热过孔是实现 PCB 层间热连接、提升纵向导热能力的关键,仅器件焊盘底部及接地管脚周边的过孔起核心散热作用。
推荐设计方案:孔径 10-12mil,孔中心间距 30-40mil,可根据器件热耗与温度控制要求调整过孔数量。
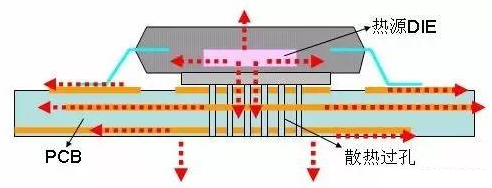
实测数据显示,增加 4×4 或 6×6 散热过孔阵后,器件结温与 PCB 正反面温度均有显著下降。

③增大散热铜箔:通过扩大覆铜面积、增加铜箔厚度(如 2.0oz 铜箔)、增加铜箔层数等方式提升散热能力。需注意铜箔需保持连续,避免分割影响热量传递效率;铺铜长度与器件热阻呈负相关,需根据器件发热情况确定最小铺铜尺寸。
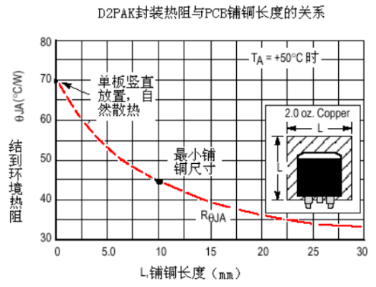
2. 散热器件选型与设计
1)散热器件选型评估标准
在环境温度 T₀条件下,用红外测温仪测试产品满载工作 2 小时后所有发热器件的实际温度 T₁,结合器件结温 Tⱼ、产品最高工作温度 Tₘ,估算极端工况下器件温度 T₂=(T₁+Tₘ-T₀)×1.2。若 T₂>Tⱼ×70% 且 T₂>Tₘ,需针对性采取散热措施。
2)散热方式设计
①风冷方式选择:
自然对流:无风扇辅助,适用于多灰尘、室外等不适宜安装风扇的工业环境;
强制风冷:通过风扇加速气流流动,散热效率高、结构简单、可靠性强,适用于室内控制室等环境优越场景。
②散热器选型:
a. 常规散热器:金属外壳产品优先选择 “散热片 + 外壳导热” 方案;嵌入式产品若 Tₘ<tⱼ×70%<t₂
选型计算逻辑:热阻 R(℃/W)= 温度差(℃)/ 热耗(W),需结合硅脂热阻(通常取 0.1℃/W)综合计算。
示例:芯片功耗 5W,表面最高允许温度 125℃,最高环境温度 75℃,则所需散热器热阻 R=(125-75)/5 -0.1=9.9℃/W,按此数值选型。
注意:普通芯片可按 “热耗≈功率” 估算,电源转换类芯片 / 模块因存在能量输出,不可直接等同,需单独核算热耗。
b. 热管散热:针对 WiFi6/7、PTP 等大功率交换机,常规散热方式无法满足需求时采用。
热管传热能力极强(热流密度超 200W/cm²),通过工质 “吸热端蒸发 - 放热端液化” 循环传热,结构紧凑、可靠性高,适用于终端电子设备。

③特殊散热设计:
双面散热:在 PCB 板正反面同时对高发热器件(如 WiFi + 交换机组合模块)进行散热处理。实测显示,70℃高温环境下,CPU 温度可从 115℃降至 97℃,降温幅度近 20℃;
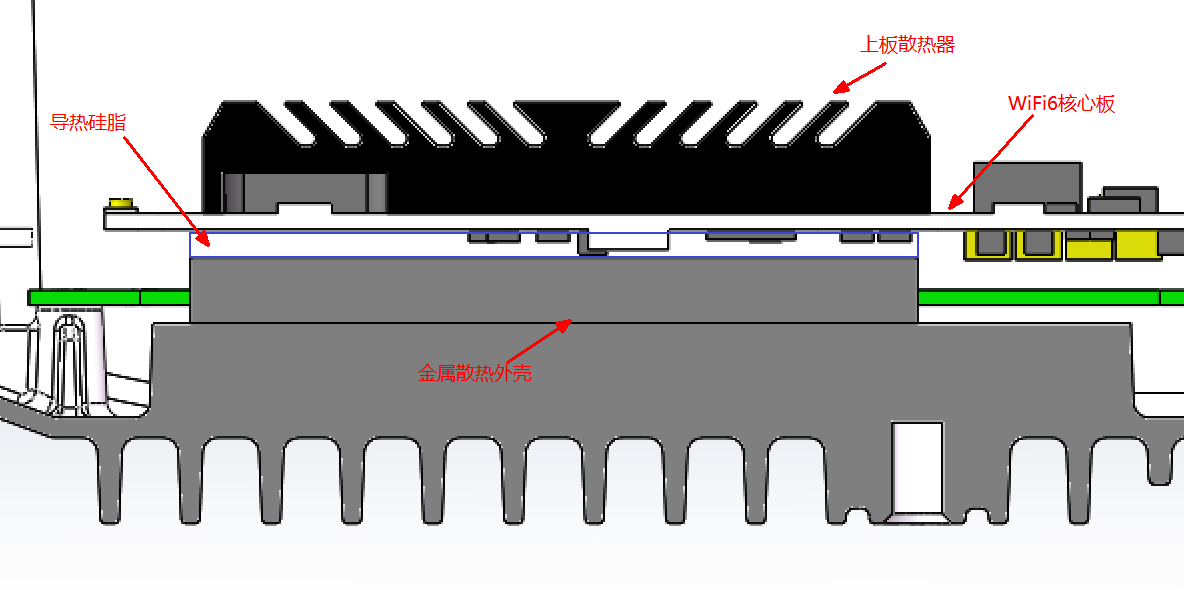
④铝块导热至外壳:
适用于高功耗场景(如总功耗 180W 的 PoE 交换机),通过铝块将防反二极管、CPU 等核心发热器件的热量传导至金属外壳。实测显示,二极管表面温度可控制在 101℃(结温 150℃),WiFi 核心板 CPU 温度降至 93.7℃(结温 125℃),符合规范要求。
3. 散热硅脂片选型
散热硅脂片的核心参数直接影响导热效果,需聚焦关键指标选型,次要参数(颜色、比重)对散热效果影响极小,可忽略。

关键参数选型标准
①厚度:厚度越小散热效果越好,散热器与外壳接触时需保证厚度≥2mm;计算公式:硅脂片厚度 = L×(1 + 压缩率)×0.9(L 为散热器与发热器件间距)。示例:2mm 间距需选择 2.25mm 厚硅脂片。
②耐温范围:需比发热器件工作温度范围宽 10%。示例:CPU 工作温度 - 40℃~125℃,硅脂片耐温范围需≥-44℃~137℃(低温可与器件最低温度一致)。
③体积电阻:需满足 “体积电阻 / 10mm× 硅脂厚度>1GΩ”,保障绝缘性能。
④耐压电压:≥6kV/mm,避免浪涌测试时出现放电现象。
⑤导热系数:根据器件表面温度选型 ——>75℃选 5W/(m・k);65℃-75℃选 3W/(m・k);50℃-65℃选 1.5W/(m・k)。
4. 散热器固定设计
根据散热器重量、发热器件功率及接触面积,选择适配的固定方式:
①导热硅胶固定:适用于散热器轻便、与发热器件接触面积大、器件功率小的场景;
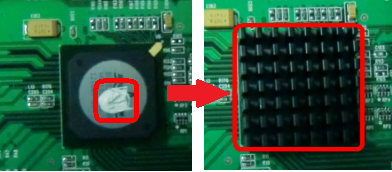
②螺丝 + 散热铝块固定:适用于散热器较重、散热面积远大于发热器件的场景,需搭配散热硅胶片增强导热,通过固定柱与 PCB 板紧固;
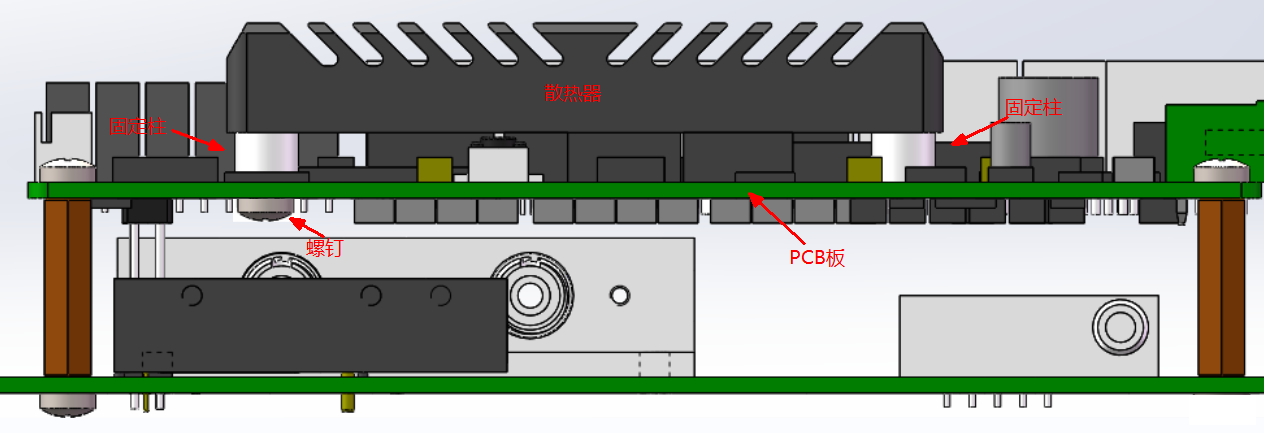
③脚钉弹簧固定:针对重量较大的散热器,需强化固定稳定性时采用;

④焊针固定:常用于功率二极管、功率 MOS 管等器件;
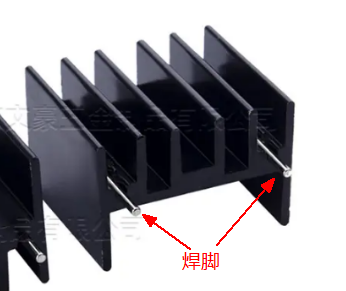
⑤双面胶固定:适用于器件发热量小、散热器轻便的场景。
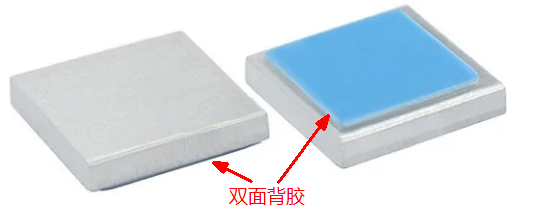
6. 散热方案验证
1)采用 “多重测试 + 对比分析” 的方式验证方案有效性,确保器件温度达标:
①热电偶测量:适用于带外壳产品,测试所有发热器件表面温度,需满足 “<器件结温 Tⱼ×90%”(温度越低越优);
②红外热成像:适用于裸板产品,直观呈现 PCB 板温度分布,定位热点区域;
2)调试口读取:针对内置温度传感器的器件,通过软件命令读取芯片内部温度,与前两种方法结果对比,取较高值作为评估依据。若测试温度达标,可进一步优化散热方式降低成本;若未达标,需重新调整设计方案。
7. 热仿真分析
热仿真是设计早期阶段的核心分析手段,通过 ANSYS、Flotherm、Cadence Allegro 等专业软件,在虚拟环境中模拟不同工作条件下电子组件与 PCB 的热响应,可精准计算温度分布、热流及热阻,快速识别热点区域。其核心价值在于指导器件布局、材料选型及散热结构优化,减少物理样机测试成本,缩短研发周期。
8. 热隔离设计
当高发热器件无法分置、且周边存在热敏器件时,需采取热隔离措施 —— 通过隔热材料(如隔热铝板)将发热器件与热敏器件隔离,避免热量传导影响敏感部件正常工作,类似汽车发动机的隔热设计逻辑。
五、总结
工业交换机的散热设计是一项系统性工程,需贯穿研发全流程,核心围绕 “源头控热、路径导热、环境散熟” 三大逻辑,整合 PCB 布局优化、散热材料选型、散热结构设计、仿真验证、热隔离等多重策略。实际应用中,需结合设备工作环境、功率需求、成本预算等具体条件灵活调整方案,实现 “散热效果、可靠性、经济性” 的平衡,确保设备在全工况下稳定运行。



